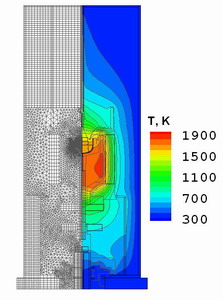 Рис. 1.
Расчетная сетка для расчета теплообмена (слева); тепловое поле
в ростовой установке (справа).
|
Рост кристаллов SiGe по методу Чохральского
Проведено моделирование роста объемного кристалла Si1-xGex по методу Чохральского при начальной концентрацией германия в расплаве 3 at% [1]. Одна из особенностей роста таких кристаллов - изменение концентрации Ge в расплаве и кристалле из-за процесса сегрегации, что учтено в наших расчетах.
На Рис.1 приведены расчетная сетка для расчета теплообмена в установке,
содержащая примерно 15 000 ячеек, и тепловое поле в ростовой установке.
Шаг между изолиниями составляет 100 K, максимальная температура — 1850 K.
На внешних стенках использовано изотермическое граничное условие (T=300 K).
Мощность нагревателя была подобрана так, чтобы обеспечить заданную
скорость кристаллизации.
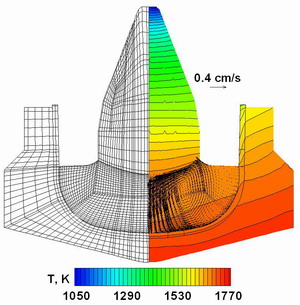 Рис. 2.
Расчетная сетка для зоны кристаллизации (слева); распределение
температуры и осредненное течение расплава, полученные в 2D расчетах
(справа).
|
Подробный анализ процессов, происходящих в зоне кристаллизации, был проведен в рамках двумерного (метод осреднени по Рейнольдсу, модель Чена) и трехмерного подходов. На Рис.2 представлены расчетная сетка в зоне кристаллизации (слева), поле температуры и картина осредненного течения, полученные в результате 2D расчета (справа). Видно, что двумерная модель предсказывает сильное ниспадающее течение вдоль оси симметрии.
Однако реальное течение расплава — трехмерное и нестационарное,
поэтому только в ходе 3D расчетов можно получить информацию о
нестационарных характеристиках течения и теплопереноса в расплаве.
Сетка для 3D расчетов содержит около 150000 ячеек (Рис.4). На Рис. 5
приведены примеры картин течений, полученных в 3D расчете. Видно,
что течение расплава имеет сложную структуру, наибольшая скорость
наблюдается в центральной области расплава и составляет 1см/с,
характерная скорость на периферии расплава — 1мм/с.
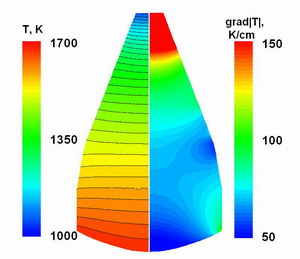 Рис. 3.
Распределения температуры (слева) и градиента температуры (справа)
в кристалле.
|
 Рис. 4.
Расчетная сетка для 3D расчетов, содержащая примерно 150000 ячеек.
|
 Рис. 5.
Примеры течения в расплаве, полученные в 3D расчетах.
|
Интересным результатом 3D расчетов являютс флуктуации скорости кристаллизации, которые возникают из-за турбулентных пульсаций расплава, что влияет на стабильность роста. В ходе расчетов было выявлено, что величина амплитуды флуктуаций скорости кристаллизации составляет 1.2 мм/час. Это объясняет тот факт, что стабильный рост кристаллов в рассматриваемой установке возможен только при скорости кристаллизации больше, чем 1 мм/час. Отметим, что такие результаты можно получить только в рамках 3D нестационарных расчетов.
Важным параметром растущего кристалла является форма фронта
кристаллизации, которая заметно влияет на процессы формировани
дефектов и встраивания примесей в кристалл. Форма фронта кристаллизации
чувствительна к любому изменению в системе, поэтому может быть
использована как критерий адекватности моделирования. Расчеты
геометрии фронта были проведены при помощи 3D и 2D подходов, которые
рассматривают течение расплава. Кроме того, была использована модель
эффективной теплопроводности, не учитывающая конвекцию. Модели
эффективной теплопроводности дает наименьший прогиб границы расплав-кристалл
и имеет наибольшее расхождение с экспериментом. Видно, что геометрия,
полученная в 3D расчете, ближе к экспериментальной форме, чем результат
2D метода. Таким образом, учет течения расплава позволяет аккуратно
описать физические процессы в ростовой установке и адекватно предсказать
форму фронта кристаллизации.
Все расчеты были проведены при помощи пакета программ
CGSim.
Литература
[1] O.V. Smirnova, V.V. Kalaev, Yu.N. Makarov, N.V. Abrosimov,
H. Riemann, J. Crystal Growth 266 (2004) 74-80.


